熱線:021-66110810,66110819
手機:13564362870


熱線:021-66110810,66110819
手機:13564362870
使用微傳感器光催化降解MC-LR
使用丹麥Unisense溶解氧微傳感器和基于鉑的、尖端直徑為50 μm的過氧化氫微傳感器測量溶解氧和過氧化氫濃度微剖面。使用3%的過氧化氫溶液校準H?O?微傳感器。DO微傳感器在氧氣飽和(23°C下21% DO,8.6 mg O? L?1)和氮氣鼓泡(0% DO)下的去離子水中進行校準。每次測量前后都對微傳感器進行校準。對于微剖面測量,將MoS?樣品置于微剖面室中,并以2 mL min?1的連續流速通入去離子水。使用三維微操縱器實現微傳感器尖端朝向樣品的定位和移動,并使用帶有CCD相機的立體顯微鏡進行觀察。使用銀/氯化銀參比電極,并使用“幫手”和實驗室千斤頂在顯微鏡視野中定位MoS?樣品。使用萬用表測量微傳感器的電信號,并在法拉第籠中進行實驗以最大限度地減少電干擾。微剖面測量以50–100 μm的間隔進行,每次測量之間等待5秒。每個參數獲得三個重復剖面,圖4中顯示的微剖面是這些重復的平均值。從MoS?薄膜表面上方2,000 μm處到溶液表面進行微剖面測量。
光催化反應與微剖面測量
將制備好的MoS?薄膜樣品(約1 cm × 1 cm)置于定制化的流動池中,池內充滿含有MC-LR(初始濃度250或500 μg L?1)的溶液。使用氙燈(配備AM 1.5G濾光片)模擬太陽光進行照射,光強調整為100 mW cm?2。在光照過程中,將DO和H?O?微傳感器分別安裝在三維微操縱器上,將其尖端精確移動到距離催化劑薄膜表面不同位置(從體相溶液到薄膜表面),以固定步長(如20 μm)測量DO和H?O?濃度的垂直剖面。測量在法拉第籠中進行以減少電磁干擾。通過比較光照與黑暗條件下,以及不同催化劑表面的微剖面,可以直觀地評估ROS生成和DO消耗的強度與空間分布。
利用XTT還原法監測ROS產生
除了微電極,采用2-甲氧基-4-硝基-5-磺基苯基-2H-四唑鎓-5-甲酰苯胺內鹽(XTT)分析法研究活性氧的產生。XTT可被超氧自由基陰離子(O???)還原生成水溶性的XTT-甲臜,其在470 nm處有最大吸收,該反應產生的甲臜可用于測定所產生的ROS的相對含量。測試了尺寸相同(3 cm2)的金屬涂層MoS?薄膜。將40 mL溶解在磷酸鹽緩沖鹽水中的XTT(0.4 mM)用于浸沒樣品,同時暴露于16,000 Lux(4.47 × 10?3 W cm?2)的連續冷白色熒光燈光照下。使用搖床以90 RPM的轉速保持樣品充分混勻。使用分光光度計在470 nm處測量吸光度,持續兩天,以確定ROS的生成速率。
MC-LR的降解與分析
在批次光催化降解實驗中,將薄膜樣品浸入50 mL MC-LR溶液(溶于去離子水,初始pH約5.8)中。在黑暗條件下攪拌30分鐘以達到吸附-脫附平衡。然后開啟模擬太陽光照射,在預定時間點取樣。樣品經0.22 μm濾膜過濾后,采用高效液相色譜-質譜聯用儀或配備紫外檢測器的高效液相色譜分析剩余的MC-LR濃度。通過MC-LR濃度的變化計算去除效率,并利用準一級動力學模型擬合降解速率常數。同時,通過X射線光電子能譜分析光照前后催化劑表面的元素化學態變化,以探究MC-LR的降解途徑。
結果與討論
圖5-1(a)是示意圖,展示了使用半導體二維MoS?光催化劑對新興水污染物進行光催化降解的概念。在二氧化硅/硅基底上生長的垂直排列二維層MoS?薄膜被浸入含有藻毒素(本例中為MC-LR)的水浴中,吸收可見光光子,從而產生電子-空穴對(e?h+)。這些電荷載流子遷移至半導體表面,與羥基離子和氧分子反應,生成高活性物種(即O???、·OH和過氧化氫),從而降解藻毒素。圖5-1(b)是尺寸大于2 cm2的二氧化硅/硅晶圓上生長的垂直排列二維層MoS?薄膜的圖像。通過硫化鉬沉積晶圓并遵循先前報道的方法,實現了垂直排列二維層MoS?薄膜的生長。圖5-1(c)是垂直排列二維層MoS?薄膜的代表性高分辨率透射電子顯微鏡圖像。
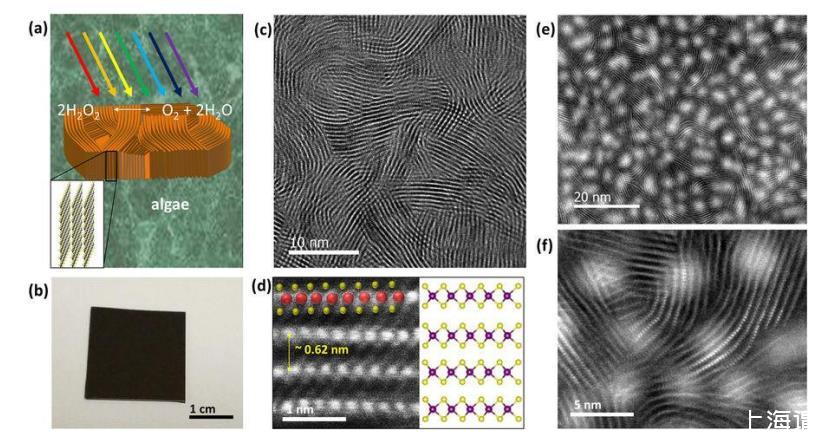
圖5-1. 垂直排列層的二硫化鉬薄膜的光催化降解概念及透射電子顯微鏡表征。(a) 使用二硫化鉬薄膜進行光催化降解的示意圖。(b) 新生成的二硫化鉬薄膜圖像。(c) HRTEM 圖像顯示垂直排列的二維二硫化鉬層。(d) 垂直排列二維層的原子力顯微鏡-掃描電子顯微鏡圖像及原子結構對比。(e) HRTEM 圖像顯示鉑納米顆粒在垂直排列二維層邊緣的均勻分布。(f) 放大圖像顯示即使摻入鉑后,垂直二維層邊緣仍保持良好狀態。
顯然,MoS?薄膜主要暴露于其邊緣平面,這通常比其基面更具催化活性。圖5-1(d)是使用像差校正環形暗場掃描透射電子顯微鏡獲得的垂直排列二維層的高分辨率圖像。原子結構疊加表明,層間距離約為0.65納米。圖5-1(e)顯示了在垂直排列二維層邊緣均勻分布的鉑納米顆粒(直徑約2-3納米)的HRTEM圖像。圖5-1(f)是鉑納米顆粒沉積在MoS?層邊緣的特寫HRTEM圖像。即使在引入鉑之后,垂直二維層的邊緣似乎仍然完好無損。
圖5-2(a)顯示了從不同厚度鉬種子層生長的MoS?薄膜的代表性拉曼光譜。隨著鉬厚度的增加,拉曼強度相應增加。此外,隨著鉬厚度從5納米增加到20納米,E1?g和A1g模式的峰位向更高的拉曼頻移移動,表明MoS?層中存在拉伸應變。E1?g和A1g模式之間的頻率差和強度比是評估MoS?層數的常用標準。圖5-2(b)顯示,頻率差和強度比都隨著鉬厚度的增加而增加,表明垂直排列MoS?層的層數增加。從具有5、10、15和20納米厚鉬層的樣品獲得的頻率差值分別為24.1、24.7、25.1和25.3 cm?1,與文獻中報道的4-6層MoS?的值一致。此外,相應的強度比值分別為1.05、1.08、1.11和1.12,與具有2-4層MoS?的樣品獲得的值相當。
然而,由于我們的MoS?樣品具有垂直排列的層,傳統的(為面內樣品開發的)層數評估可能會給出不同的值。為了驗證這一點,我們檢查了MoS?薄膜的光學特性。圖5-2(c)顯示了從不同鉬厚度樣品獲得的光致發光光譜。與塊體MoS?典型的弱光致發光信號相反,我們的垂直排列MoS?薄膜即使在20納米厚的樣品中也表現出強烈的光致發光信號,這與先前報道的垂直排列MoS?結果一致。
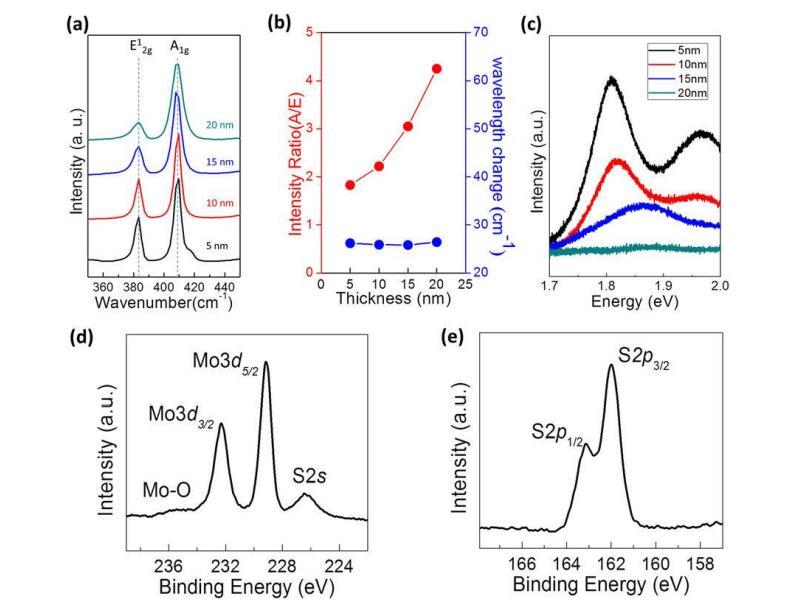
圖5-2. 通過拉曼光譜、光致發光(PL)和 XPS 進行的結構與化學表征。(a) 從不同厚度鉬種子層生長的二硫化鉬薄膜獲得的拉曼光譜。(b) A1g/E1 2g強度比及A1g?E1 2g頻率差隨鉬厚度的變化關系。(c) 從相應二硫化鉬薄膜獲得的PL光譜。(d) 二硫化鉬薄膜的 XPS 光譜,顯示Mo3d和(e) S2p核心能級。
 相關新聞
相關新聞